TEM Principle
The Transmission Electron Microscope (TEM for short) projects an accelerated and focused electron beam onto an extremely thin sample. Electrons collide with atoms in the sample and change direction, producing angular scattering. The magnitude of the scattering angle is related to the sample's density and thickness, thus forming bright and dark images.
Instrument Model and Technical Parameters
- Instrument Model: JEOL 2100
- Technical Parameters:
-
- Acceleration Voltage: 200 kV
-
- Maximum Magnification: 25–1,050,000×
-
- Point Resolution: 0.24 nm
-
- Line Resolution: 0.14 nm
-
- Maximum Sample Stage Tilt Angle: ±30°
-
- Selected Area Diffraction Camera Constant (mm): 60–4,600
-
- Electron Gun: LaB6 Filament
Sample Submission Requirements and Notes
- Powder samples: 50–100 mg
- Liquid samples: 0.5–1 mL, organic-free
- Samples with magnetism must be declared in advance.
Testing Cases
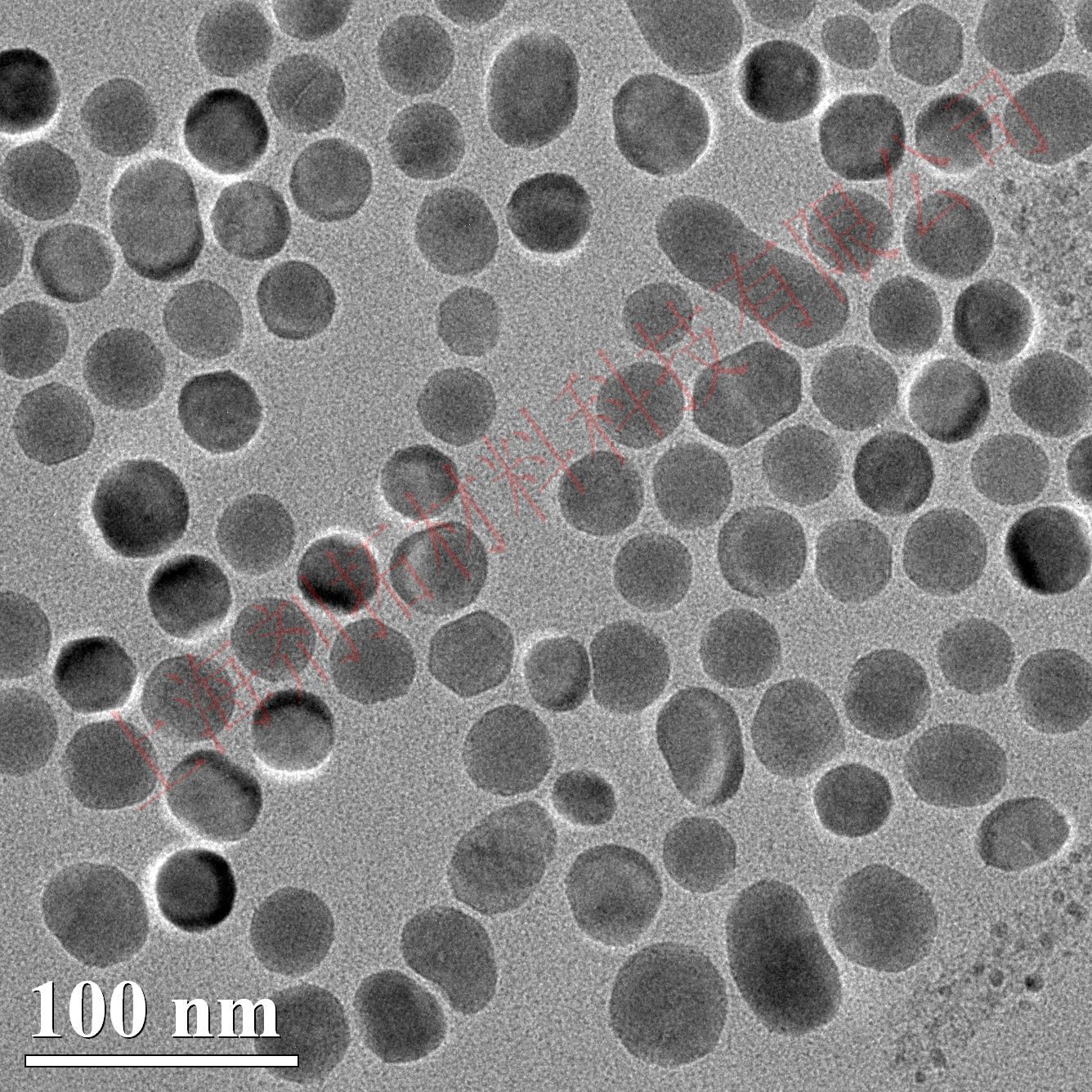
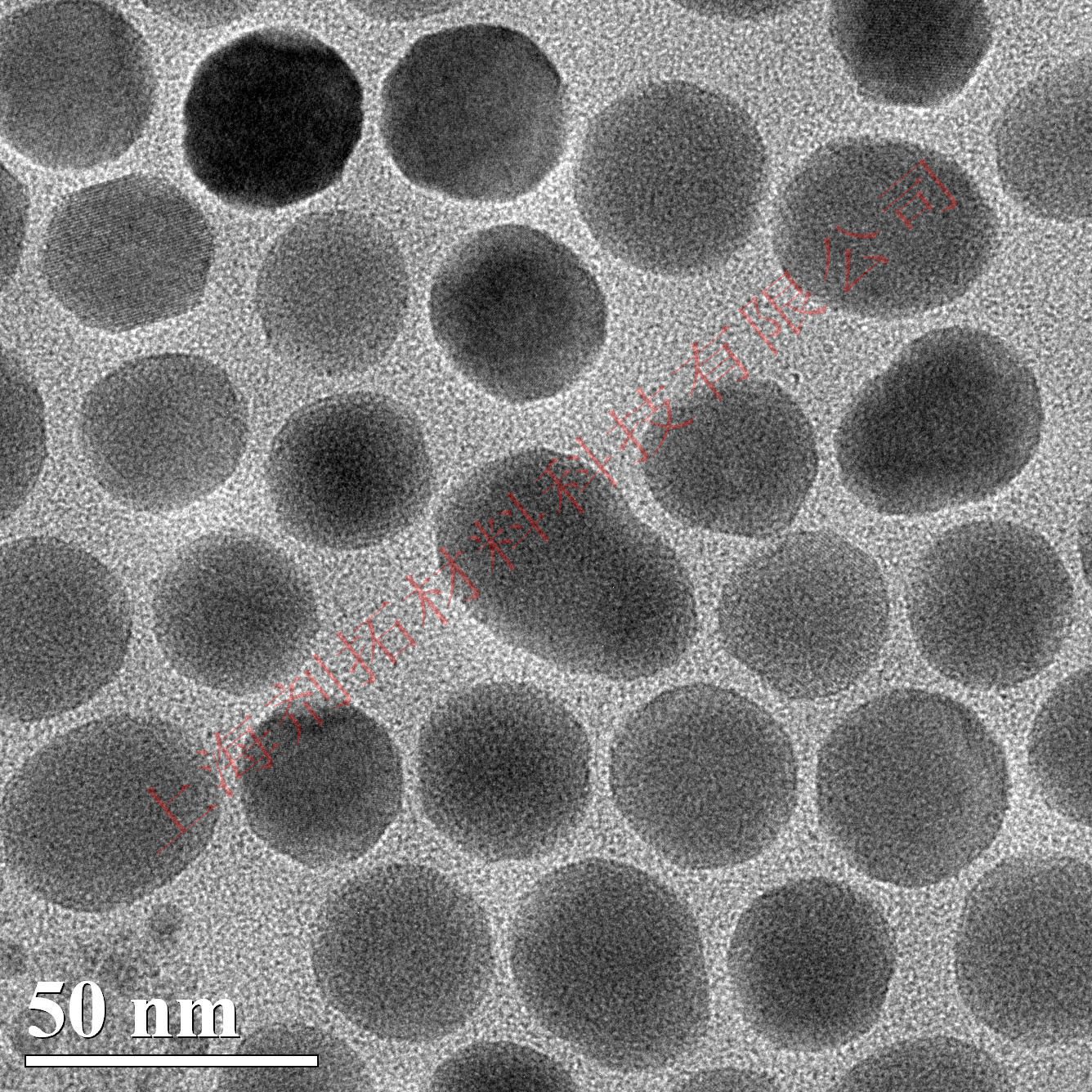
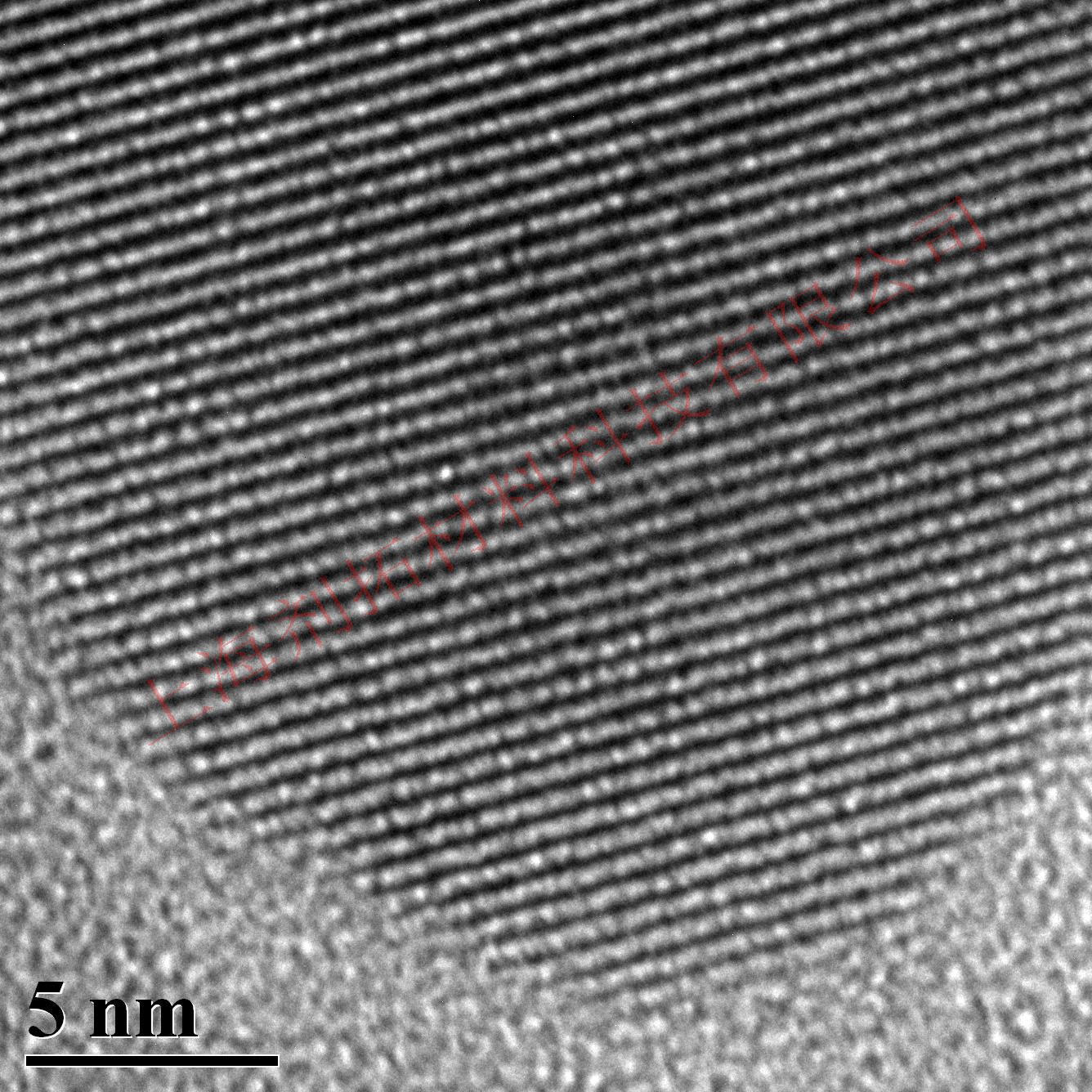
Reference Standards
- ISO 21363:2020 Nanomaterials — Determination of particle size distribution and morphology by transmission electron microscopy (TEM)
- ISO 19214:2017 Microbeam analysis — Method for calibration of selected area electron diffraction (SAED) in TEM
- ASTM E3143-18b Standard Guide for Calibration of Resolution and Magnification in Transmission Electron Microscope (TEM) Images
- ASTM F1877-22 Standard Practice for Preparation of Transmission Electron Microscope (TEM) Samples of Semiconductor Devices